Центр радиофотоники и СВЧ технологий образован на базе НОЦ «Нанотехнологии» НИЯУ МИФИ одного из самых высокотехнологичных R&D центров России.
Инфраструктура включает в себя несколько лабораторий с участками класса чистоты ISO6 – ISO8. Площадь помещений более 1300 м2. Диаметр обрабатываемых пластин – 3 дюйма и 4 дюйма.
Основной задачей являются исследования и разработки в области радиофотоники, квантовой сенсорики, СВЧ электроники и т.д. Фундаментальные исследования связаны с созданием новых наноматериалов гетероструктур на основе AIII BV, в том числе нитридных, разработкой технологий эпитаксии, нанолитографии с топологической нормой до 50 нм для формирования радиофотоннных квантовых устройств и нанотранзисторов.
Структура технологических участков
Обеспечивается непрерывность исследовательского процесса и опытной технологии на полномасштабной линейке технологического оборудования весь цикл «от фундаментальных исследований к готовому прибору».

Основные направления научной деятельности:
- Радиофотоника
- Квантовая сенсорика
- Гетероструктурная СВЧ электроника
- Физика и технология широкозонных полупроводников
- Нанотехнологии в электронике
Оснащение
Система электронной литографии оснащена катодом Шоттки и обеспечивает разрешение во вторичных электронах до 2 нм при ускоряющем напряжении 50 кВ. Электронная оптика прибора обеспечивает отклонение тока пучка не более 1% от установленного значения за 5 часов непрерывной работы. Передвижение объектов осуществляется с помощью трехосевого столика, а благодаря интерферометрам по осям X и Y позиционирование выдерживается с точностью 10 нм. Совокупность малого диаметра, высокой стабильности электронного зонда и точности перемещения интерферометрического стола обеспечивает литографическое разрешение до 10 нм.

Система электронной литографии высокого разрешения Crestec CABL- 9000C, Япония
- Электронная растровая микроскопия высокого разрешения (не хуже 2-5 нм).
- Нанолитографии с размерами получаемых элементов не хуже 15-20 нм.
- Диаметр пластин до 150 мм.
Современная технология изготовления грибообразных затворов СВЧ-транзисторов с длиной затвора Lg =100-250 нм, в перспективе - до 35÷50 нм
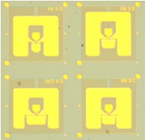
- Создание квантовых наноразмерных приборов.
- Создание прототипов суб-ТГц транзисторов.

- Грибообразный затвор СВЧ транзисторов Lg 120 нм
- Создание многослойных гетероструктур с двумерным электронным газом для транзисторов и МИС СВЧ электроники и сенсоров.
- Фундаментальные исследования по самоорганизации наносистем и созданию перспективных материалов электроники.
Установка Молекулярно-лучевой эпитаксии Riber 21 T 3-5, Франция

Молекулярно-лучевая эпитаксия гетероструктур группы А3В5 на подложках GaAs, InP. Максимальный диаметр используемой подложки для нанесения эпитаксиальных слоев 76 мм (3 дюйма).
Установка состоит из 3-х вакууммных камер: камера роста, камера подготовки, камера загрузки. Все камеры оснащены системами безмаслянной откачки и разделены между собой высоковакуумными затворами.
Имеется 5 источников молекулярных потоков.
Для СВЧ электроники:
- РНЕМТ (X, Ku диапазон)
- НЕМТ/InP (Ka, мм-диапазон, суб-ТГц)
Развитие новых подходов:
- Самоорганизация квантовых точек и колец, материалы для сенсоров, фотодетекторов.
- Варизонные гетероструктуры и составные квантовые ямы.
- Создание многослойных гетероструктур с двумерным электронным газом для транзисторов и МИС СВЧ мощной и силовой электроники
Установка Молекулярно-лучевой эпитаксии «GEN 930», компания Veeco, США

Система позволяет формировать высококачественные равномерные полупроводниковые эпитаксиальные слои или структуры на подложках диаметром до 76 мм (3 дюйма) для радиационно-стойких приборов СВЧ и силовой электроники.
Установка имеет модульную структуру и включает одну камеру роста в условиях сверхвысокого вакуума (СВВ), 1 камеру предварительной подготовки в условиях СВВ и одну камеру загрузки.
Установка газофазной эпитаксии CMI, США
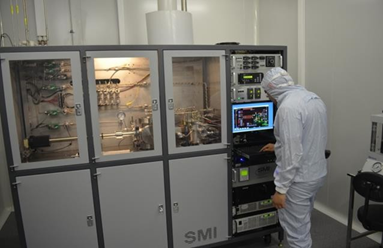
Установка предназначена для эпитаксии из газовой фазы монокристаллических слоев карбида кремния кубической политипной модификации с необходимыми толщинами, уровнями легирования и механическими напряжениями на подложках кремния.
Температура подложки до 1350 °С. Максимальный диаметр пластин 100 мм.
Система TFS 200 для получения тонких пленок методом ALD ( Beneq, Финляндия)

Осаждение диэлектрических материалов (Al2O3) для фотовольтаики, гибкой электроники, новых элементов питания, приборов СВЧ и оптоэлектроники.
Преимущества:
- Прецизионный контроль толщины пленки.
- Отсутствие пор и дефектов поверхности – превосходные барьерные и пассивационные свойства.
- Равномерное покрытие как на плоских подложках большой площади, так и на поверхностях сложной формы, включая пористые материалы и порошки.
- Новые материалы и низкоразмерные структуры, такие как наноламинаты.
- Стабильные и легко масштабируемые для нужд коммерческого производства процессы.
Установка для плазмохимического осаждения из газовой фазы LPX PECVD (Великобритания) и

Установка PECVD предназначена для осаждения SiNx, SiO2 из газовой фазы на подложки с использованием плазменного разложения реакционного газа.
Установка травления предназначена для проведения реактивного ионного травления многослойных гетероструктур нитридов алюминия-галлия–индия на подложках лейкосапфира или карбида кремния. Травления сквозных отверстий в подложках фосфида индия и арсенида галлия.

Введены в работу две установки плазмохимического травления:
Plasma Therm ICP Cl (Cl2, BCl3):
- Травление полупроводников A3B5: GaAs, GaN, InP.
- Глубокое травление SiC.
- Травление металлов: Au, Cr, Al, Ti.
Plasma Therm ICP СІ имеет ВЧ генератор 600Вт, для травления с большими скоростями. Новые возможности: нагреваемый стол образца до 350 °С для травления InP гетероструктур для радиофотоники
Plasma Therm ICP F:
- Глубокое травление Si (bosh процесс, криопроцесс)
- Травление диэлектриков Si3N4, SiO2
Plasma Therm ICP F проведение как стандартного травления кремния, так и криопроцессы с температурой ниже <-100 °C. Новое оборудование имеет устройства In-situ контроля процессов травления.
Системы осаждения тонких пленок Kurt J. Lesker PVD 250 и PVD 75, США

Системы осаждения тонких пленок позволяют наносить металлы методом термического, электронно-лучевого испарения и магнетронного распыления.
- Подогрев подложек до 350°С.
- Возможность попеременного напыления 6-ти материалов в одном процессе.
- Напыление на 13 подложек диаметром 4″ в одном процессе.
- Возможность напыления соединений металлов (оксиды, нитриды) методом реактивного магнетронного распыления.
Установка быстрого термического отжига Modular RTP600S позволяет проводить термическую обработку контактов до 1200 °С в инертной среде.
Система безмасковой лазерной литографии DWL 66FS (Heidelberg Instruments Mikrotechnik GmbH, Германия)

Система высокопрецизионной безшаблонной литографии с использованием лазерной литографии. Может использоваться для нанесения маски или прямого экспонирования на любой плоской поверхности покрытой фоторезистом.
Диаметр подложек до 200 мм. Вспомогательная адресная сетка до 50 нм. Множественные режимы рисования. Векторный и растровый режимы экспонирования. Наличие камеры для ориентации (совмещения). Камера искусственного климата. Сменные пишущие головки.
Установка контактной литографии микросхем Suss MJB4 (SUSS MicroTec, Германия)
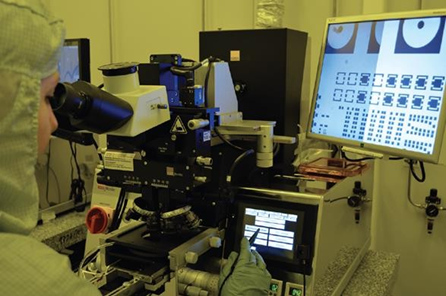
Экспонирование высокого разрешения – до 0,4 микрон (в глубоком ультрафиолете).
Максимальный размер обрабатываемых пластин и подложек - до 100 мм диаметром (пластины) и до 100×100 мм (подложки). Специальные держатели для кусков пластин, АIIIBV, толстых подложек, гибридных схем и ВЧ. Высокоточная юстировка на плоскости и манипулятора микроскопа.
Контроль толщин различных пленок и глубин травления осуществляется с помощью контактного профилометра Dektak XT.
Установка для планаризации поверхности материалов ускоренными ионно-кластерными пучками - nAccel 100 (Exogenesis, США)

Основные параметры установки:
- Рабочий газ – аргон (возможно использовать и другие газы).
- Поток в пучке – 5 × 1014¸ 1 × 1016 частиц/секунду.
- Размер обрабатываемой области около 5 мм x 5 мм.
- Возможность обрабатывать образцы площадью до 310 x 310 мм2 (в случае подключения автоматического сканера.
- Давление в камере ионизации: <10-6 Торр.
- Давление в камере с образцом: <5∙10-3 Торр.
Установка утонения Logitech LP50, Великобритания;
Установка прецизионной дисковой резки серии ADT 7100, Израиль.

Утонение образцов от толщин 2-3 мм до 50 мкм, диаметром до 150 мм.
Резка может производиться для нескольких подложек одновременно. Установка оснащена автоматической системой машинного зрения с функцией плавного цифрового видеомасштабирования.
Фронтальное расположение шпинделя и чугунное основание уменьшают вибрации и тепловыделение.
Размеры обрабатываемых подложек/пластин: до 200мм х 200мм/до Ø200мм.
Размеры дисков: 2"-3".
В НИЯУ МИФИ запущен новый времяпролетный TOF-SIMS вторично- ионный масс-спектрометр для анализа химического состава поверхности, глубинного профилирования состава и 3D картографирования.

Технические параметры:
- Максимальный размер образцов – до 100 мм.
- Тип пучков пушек – О2/Cs (травление) + Bi (анализ).
- Время импульса – 0.7 нс.
- Максимальная энергия – 30 кВ.
- Латеральное разрешение анализа (Bi пучок) – до 70 нм.
Сканирующий электронный микроскоп c интегрированной ионной колонной (SEM-FIB) LIRA 3 (Tescan, Чехия)

Исследование топографии и структуры поверхности, получение изображения во вторичных и обратно- рассеянных электронах. Рентгеноспектральный микроанализ элементного состава с использованием энергодисперсионного спектрометра (EDS). Наличие встроенного детектора In beamSE (Secondary Electron) позволяет получить изображение с улучшенным контрастом и разрешением по сравнению со стандартным детекторам.
Паспортное разрешение – 1,2 нм. Анализ элементов от 5B до 92U. Полностью безмасляная система откачки, вакуум в камере для образцов 10-6 торр, вакуум в электронной пушке и электронно-оптической колонне 10-7 Па.
Возможность съемки образцов большого размера 400×400 мм.
Комплекс измерений S-, X- параметров PNA-X N 5245A, СШ. Зондовые станции PM8 и ЕР6

Комплекс измерений S-, X- параметров PNA-X N 5245A обеспечивает во всей рабочей полосе измерения S-, X- параметров, измерение интермодуляционных искажений, измерение компрессии коэффициента усиления в диапазоне частот 0,01 – 50 ГГц.
Измерительный комплекс В1500А позволяет проводить автоматизированные измерения ВАХ от 0,1 фА до 100 мА и ВФХ на частотах до 5 МГц.
Имеется тестер Formula TT для измерения ВАХ в диапазоне токов до 10 А и напряжений до 2 кВ.
- Спектрометрический комплекс на основе монохроматора МДР-41, Россия;
- Спектроскопический эллипсометр PHE-102, США;
- ИК-Фурье спектрометр FTIR-8400S, Япония.

- Спектрометрический комплекс предназначен для регистрации спектральных характеристик источников излучения и фотоприемников, измерения спектров пропускания, зеркального и диффузного рассеяния, регистрации спектров фото- и электролюминесценции экспериментальных образцов в диапазоне длин волн от 250 до 1200 нм.
- Мощный и универсальный эллипсометр для проведения исследований широкого круга материалов: диэлектрики, полимеры, полупроводники, металлы, многослойные структуры. Позволяет работать в широком диапазоне длин волн (250-1100 нм) с высоким спектральным разрешением.
- ИК-Фурье спектрометр используется для определения характеристик экспериментальных образцов по форме их спектров в инфракрасной области. Спектральный диапазон: 7800–350 см-1.
3D сканирующий лазерный Рамановский спектрометр Confotec NR500, Беларусь

Установка предназначена для измерения Рамановских/люминесцентных спектров в точке, а также записи 2D и 3D изображений различных микрообъектов при сканировании сфокусированного лазерного излучения по поверхности объекта.
Лазерный Рамановский спектрометр рассчитан для использования совместно с прямым микроскопом типа Nikon Ni.
В качестве источника возбуждения образца используется лазер с длиной волны 532 нм.
Спектральный диапазон регистрации излучения откликов образцов – от 400 до 1100 нм.
Рентгеновский дифрактометр RIGAKU Ultima IV, Япония

Установка предназначена для проведения фазового анализа, степени кристалличности, размера кристаллитов, анализа остаточных напряжений, прецизионных измерений параметров решетки, оценки толщины пленки (рефлектометрия), текстурного анализа (ориентация зерен, подложки), качества интерфейса.
Направления исследований
Электрооптический модулятор
Преимущества радиофотонных систем:
- Низкие потери при передаче сигнала на длинные (км) расстояния
- Широкая полоса частот аналоговых оптических трактов
- Малые размеры и масса оптических волноводов
- Высокая надежность и долговечность
Структурная схема элементов модулятора:
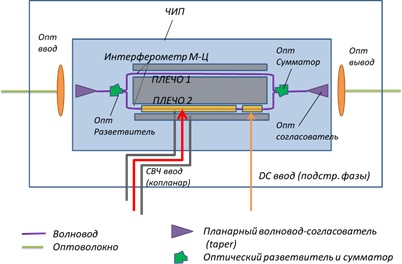
Радиофотонный тракт

Модель распределения электрического поля

РЭМ-изображение элемента модулятора
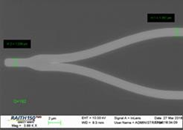
Основные технические характеристики
- Рабочие оптические длины волн 1530 … 1610 нм.
- Рабочий диапазон частот более 10 ГГц.
- Вносимые оптические потери (без учета потерь на ввод/вывод оптического излучения) не более 9 дБ.
- Полуволновое напряжение не более 7 В.
Излучающие матрицы ТГц диапазона на основе фотопроводящих антенн
Разработка технологии создания излучающих матриц ТГц диапазона (0,2 – 4 ТГц) на основе фотопроводящих антенн / оптических ключей на основе фотовозбуждения фемтосекундным лазерным импульсом
Планируемые результаты:
- Диапазон излучения – 0,8 – 4 ТГц;
- Мощность (средняя) - 1 мВт;
- Материалы – низкотемпературный GaAs , InGaAs;
- Разработка МЛЭ технологии роста гетероструктур;
- Разработка топологии и технологического маршрута, изготовление опытных приборов;
- Тестирование и испытание приборов на эффективность преобразования;
Одиночные NV-центры в алмазе. Применение

Преимущества NV-центров: локализация состояния от внешней среды без охлаждения при глубоком залегании.
Если NV-центры приповерхностные, они, крайне чувствительны к внешней температуре и магнитному полю – возможно создание микроскопических термометров и сенсоров магнитного поля.
Одиночные NV-центры в алмазе. Получение
Были получены образцы алмаза, обогащенные изотопом углерода-13. Экспериментальные образцы содержали CVD дельта-слой NV.
+13C. Концентрация NV-центров в дельта-слое ~ 5 ppb (30%) и ~ 30 ppb (100%).
Методом КРС было изучено распределение изотопного состава в образцах алмаза с гомоэпитаксиальными слоями. Ниже приведены данные для образца, содержащего слой 13С с концентрациями изотопа 30%.

Карта участка торцевой поверхности пластины, полученная с помощью ПЗС-матрицы:
- Мощность лазера: ~3 мВт ( = 488 нм);
- Размеры области скана: 30 х 50 мкм;
- Время сбора в точке – 3 с.

Распределение площади пика от 13C, полученное после обработки спектральной карты участка полированного торца пластины
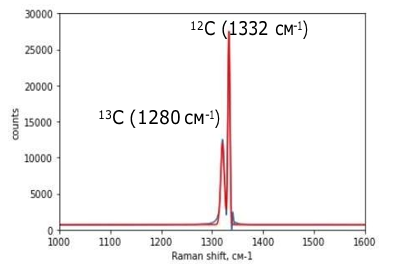
Пример аппроксимации спектра (красной линией обозначена аппроксимирующая линия)
На основе полученных экспериментальных результатов была разработана методика исследования изотопного состава CVD слоев алмаза по картам КРС, которая позволяет определять концентрацию и распределение изотопа 13С по толщине образца.
Одиночные NV-центры в алмазе. Исследования

Скан области 2 х 2 мкм с одиночным NV-центром (соотношение сигнал/шум = 100)

Автокорреляционная функция G2 от одиночного NV-центра


ОДМР спектры обнаруженного объекта при различном внешнем магнитном поле после оптимизации по мощности лазера накачки и мощности управляющего СВЧ сигнала.
Твердотельная электроника на основе GaN. Гетероструктуры с ультратонким AlN барьером
Сравнение параметров AlN/GaN HEMT-гетероструктур на основе III-нитридов, полученных методом МЛЭ
|
Изготовитель |
Метод выращивания ГС |
Тип структуры |
Подвижност ь носителей см2/(B×c) |
Слоевая концентраци я носителей, см-2 |
Слоевое сопротивление, Ом/ÿ |
|
SVT Associates (США) |
MBE (плазма) |
AlN/GaN на Al2O3 |
1780 |
2,5 х 1013 |
140 |
|
University of Notre Dame (США) |
MBE (плазма) |
AlN/GaN на темплейтах GaN |
1513 |
3,21 х 1013 |
129 |
|
НИЯУ МИФИ |
MBE плазма |
AlN/GaN на Al2O3 |
1060 |
2,58 х 1013 |
228 |
|
ИФП СО РАН |
MBE (аммиак) |
AlN/GaN на Al2O3 |
1200 |
1,3 х 1013 |
400 |
|
Курчатовский Институт |
MBE (аммиак) |
AlN/GaN на Al2O3 AlGaN/GaN (x=40) |
300 1500 |
- 1,5 х 1013 |
950 290 |
Твердотельная электроника на основе GaN. Дискретный транзистор
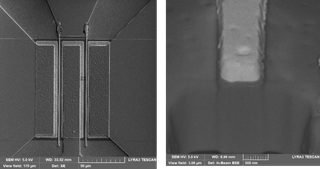
РЭМ изображения топологии двухзатворного тестового транзистора (слева) и поперечного сечения затвора, полученного методом ФИП (справа). Параметр Lg ~ 900 нм.

Семейство выходных характеристик тестового транзистора (при изменении UG от -4 до +2,25 В)

График крутизны характеристики Gm (UG) при напряжении питания на стоке 12 В

Частотная зависимость коэффициента усиления Мэйсона U
Твердотельная электроника на основе GaN. Усилитель мощности
- Диапазон рабочих частот 12…14 ггц;
- Коэффициент усиления на центральной частоте рабочего диапазона – не менее 7 дб;
- Уровень выходной мощности в непрерывном режиме ~ 30 Вт (ранее достигнуто 12,5 Вт);
- Номинальное напряжение питания («сток-исток») – 24 В;
- Коэффициент полезного действия ~ 40% (ранее достигнуто 30%.
Решается задача суммирования мощности от нескольких кристаллов СВЧ усилителей с использованием суммирующих плат в технологии корпусирования.
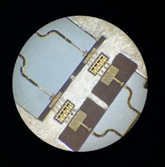
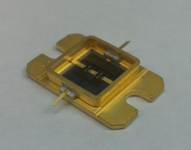
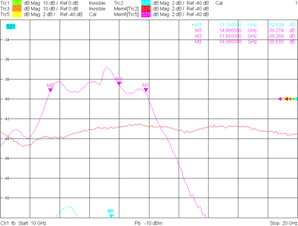
Зависимость коэффициента усиления (фиолетовая линия) от частоты (уровень ослабления – красная) при малосигнальных измерениях.
Твердотельная электроника на основе AIIIBV. Метаморфные гетероструктуры InAlAs/InyGa1-yAs c содержанием InAs от37% до 100%
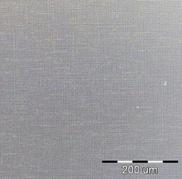

Поверхность 1dМНЕМТ (InAs-37%): Слева: оптическая МС/Номарски контраст и справа: АСМ скан.
Гетеросистема InxAl1-xAs/InyGa1-yAs, подложка GaAs диам. 2 и 3 дюйма.
- Содержание InAs: х, у = 37-38%;
- Подвижность электронов (295 К): 8390 ÷ 8580 см2/Вс;
- Концентрация электронов (295 К): 2.45 ÷ 3.0 х 1012 см-2;
- Шероховатость RMS: 1,5 ÷ 2,7 нм;
- Неоднородность r, μ, n на диам. 76 мм – не более 0,6 % по тестам Холла;

Тест однородности электронных параметров
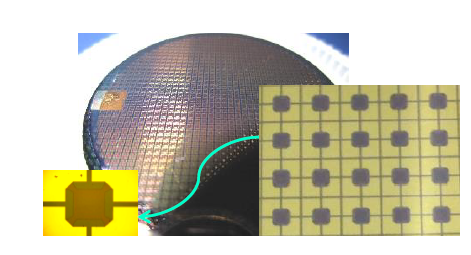
Твердотельная электроника на основе AIIIBV. Дискретные транзисторы с длиной затвора 120 нм для К- диапазона
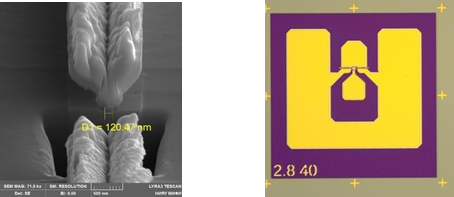
МНЕМТ гетероструктуры InAlAs/InyGa1-yAs, диаметр 3” содержание In-37%.
- Затвор – по технологии электронно-лучевой нанолитографии, Ratih 150TWO
- Длина затвора: 110÷120 nm
- Крутизна: 380 – 450 mS/mm
- Начальный ток стока: 350 ÷ 400 mA/mm
- Граничные частоты усил: Ft = 53 GHz, Fmax = 98 GHz

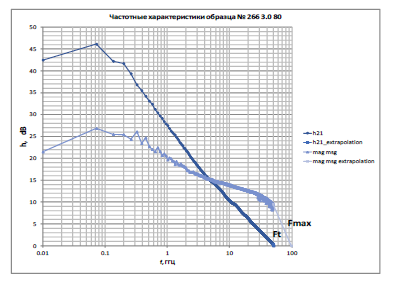
ВАХ S-параметры МНЕМТ
Твердотельная электроника на основе AIIIBV. Замкнутый цикл разработки интегральных схем – от гетероструктуры, комплекта фотошаблонов до измерений на чипах.
Срок изготовления 9-12 недель.
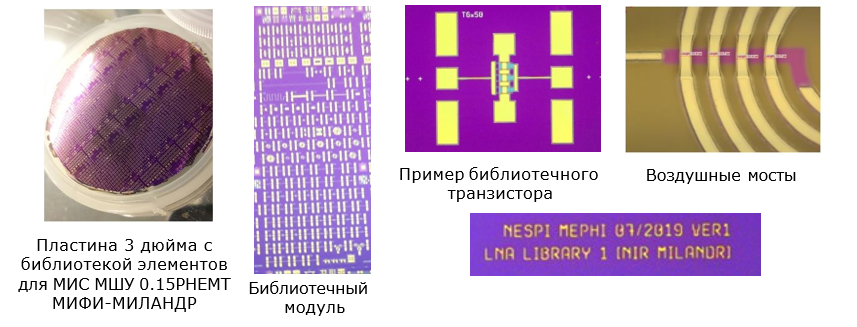
В МИФИ успешно создана библиотека элементов для СВЧ МИС МШУ (2019-20 г). В 2021 г ведется изготовление МИС 2х и 3х каскадного МШУ в интересах «Миландр».

Нелинейная модель рНЕМТ 150 нм транзистора НИЯУ МИФИ в среде AWRDE Microwave office
Комплекс для онлайн - исследования радиационной стойкости гетероструктур
В соответствие с протоколом НИР НИЯУ МИФИ – ОИЯИ (Дубна) создан оригинальный измерительный комплекс для онлайн исследования изменения электрических параметров новых гетероструктурных материалов в нейтронном потоке реактора ИБР-2 (г Дубна). Начало эксплуатации – 14 мая 2021 г. (V цикл реактора).

Комплекс позволяет проводить измерения ВАХ, удельного сопротивления, эффекта Холла, подвижности и концентрации носителей тока в образцах гетероструктур в магнитном поле 0,1 Тл в условиях непрерывного облучения пучком реакторных нейтронов с контролем температуры (доза до 1Е19 см-2).
Квантовые каскадные лазеры средней и дальней инфракрасной (терагерцовой) областей спектра, построенных на основе полупроводниковых наногетероструктур.
Комплексная разработка ККЛ: моделирование дизайна ККЛ, изготовление гетероструктур методом молекулярно-пучковой эпитаксии, изготовление прибора методами микро- и наноэлектроники, измерение свойств ККЛ и оптимизацию конструкции и технологии.
Разработка и изготовление ККЛ различного назначения:
- λ ~ 4 – 5 мкм, P ~ 1 Вт, Т > 300 K. InGaAs/InAlAs на пластинах InP
- λ ~ 8 – 12 мкм, Р ≤ 1 Вт, T ~ 300 K. InGaAs/InAlAs изоморфные с InP
- λ ~ 100 мкм (f ~ 3 ТГц), Р ~ 10 мВт, Т > 150 K. GaAs/AlGaAs на пластинах GaAs
- Разработка дизайна структур
- Выращивание структур методом МПЭ
- Разработка технологического маршрута и процессинг эпитаксиальных структур
- Тестирование приборов
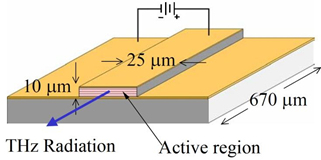
Массивы элементов спинтронных устройств
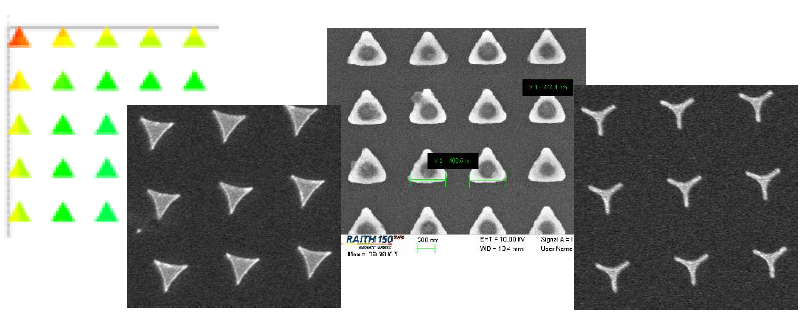
- Разработана технология получения ансамбля наномагнитных треугольных элементов при помощи электронно-лучевой нанолитографии и металлизации, топологический размер: 100 – 350 нм.
- Разработанные технологии позволяют получать массивы элементов спинтронных устройств. Технология пригодна для формирования 2D фотонных кристаллов.

Исследования ферромагнитного резонанса и вращения Керра на массивах магнитных элементов Georgia State University, USA
Обработка поверхности (шероховатость < 0.2 нм)..
Применения:
- Полировка пластин для электронных устройств;
- Линзы и зеркала для точных оптических систем (телескопы, лазеры и т. д.);
- Обработка компонентов протезирования;
- Ультратонкие легирующие слои – устройства высокочастотной наноэлектроники.

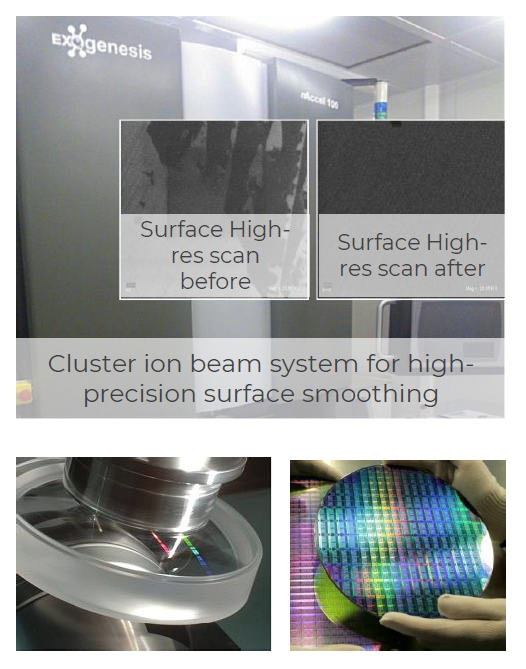
Бета-вольтаический источник питания
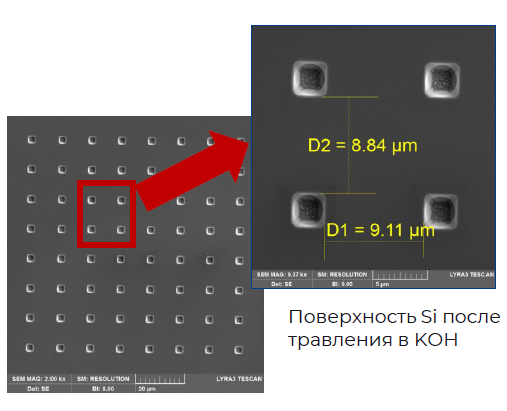
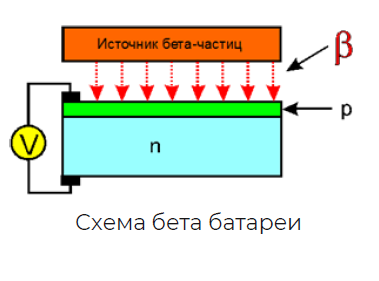

Преимущества:
- Длительный срок службы;
- Надежность;
- Низкие потери (утечки).
В НИЯУ МИФИ сформирован крупный научно-технологический центр с линейкой исследовательского и технологического оборудования в области некремниевой электроники.
Гибкость технологической линейки позволяет вести прикладные разработки по созданию опытных образцов устройств твердотельной электроники в цикле «фундаментальные разработки – опытный прибор» в области фотоники, квантовой сенсорики, СВЧ и силовой электроники и т.д.
Современный уровень технологии позволяет проводить фундаментальные научные исследования в области физики низкоразмерных систем, наногетероструктур, перспективных материалов электроники на мировом уровне.
Контакты



















